Global technical cooperation from the perspective of extreme ultraviolet lithography development
-
摘要: 在针对芯片的"卡脖子"技术中, 极紫外(EUV)光刻是最重要的一环。EUV光刻技术已经被广泛应用于最先进工艺节点的集成电路芯片制造之中。它的研发交叉融合了光学、机械、电子、控制、软件、材料、数学、物理等多个学科的知识。EUV光刻的发展反映了世界范围内联合研发的演变过程, 开放和合作是发展过程中的主旋律。回顾了EUV光刻的发展历史及所涉及的重大项目和机构, 讨论了全球唯一的EUV光刻机制造商——ASML公司的灵活多变的国际化合作路线, 分析了自1997年以来世界各代表性研发机构的研发趋势以及与EUV光刻发展的关系, 详叙了各参与机构在世界范围内的合作对EUV光刻发展的影响。该研究为研发先进光刻机等类似高端装备提供了一些启示和参考。Abstract: Extreme ultraviolet (EUV) lithography is the most important part of the "neck" technology for chips. EUV lithography technology has been widely used in the manufacturing of integrated circuit chips with the most advanced process nodes. Its research and development cross integrates the knowledge of optics, machinery, electronics, control, software, materials, mathematics, physics and other disciplines. The development of EUV lithography reflects the evolution of joint research and development worldwide, and openness and cooperation are the main themes in the development process. The development history of EUV lithography and the major projects and institutions involved were reviewed. The flexible international cooperation route of ASML, the world's only EUV lithography manufacturer, was discussed. The research and development trends of representative research and development institutions in the world since 1997 and the relationship with the development of EUV lithography were analyzed. The influence of worldwide cooperation among participating institutions on the development of EUV lithography was described in detail. This research provides some enlightenment and reference for the research and development of advanced lithography machines and other similar high-end equipment.
-
Keywords:
- integrated optics /
- lithography /
- extreme ultraviolet /
- integrated circuit /
- cooperation /
- development
-
-
表 1 EUV光刻主要项目/组织简介
Table 1 Brief introduction of EUV lithography main projects/organizations
项目/组织名称 主要成员 研究目标及方向 EUV LLC Intel和美国能源部牵头成立了EUV LLC,包括AMD,Motorola,Micron,Infineon和IBM等公司和三大国家实验室(LBNL,LLNL和SNL)[14] 致力于EUVL生产设备和工艺技术的研究开发;
持续时间:1997年~2003年SEMATECH 核心成员包括台积电、格罗方德、惠普、IBM、Intel、联电以及纽约州立大学奥尔巴尼分校的纳米科学与工程学院(CNSE)[23-24] 其宗旨是加速美国半导体产业的技术创新向制造方案的商业化转化;
创建时间: 1987年EUCLIDES(Extreme UV Concept Lithography
Development System)由ASML领衔,成员还包括卡尔蔡司、牛津仪器、飞利浦、TNO-TPD、FOM、PTB和FhG-IWS[25] 评估EUVL作为分辨率为70 nm及以下的可行光刻解决方案;
创建时间: 1998年MEDEA+(Microelectronics Development for European Applications+) 参加MEDEA+计划的企业有阿尔卡特公司、伯施公司、布尔公司、飞利浦、ST微电子公司、ASML、蔡司、爱立信、诺基亚及汤姆逊多媒体公司[26] MEDEA+计划最重要的目标是加速技术的开发,在这方面主要是确定芯片尺寸的进一步小型化。MEDEA+计划侧重一些对全球竞争有战略意义的关键技术:如系统芯片设计方法和软件工具、芯片基础技术(例如光刻)以及对欧洲半导体工业具有战略重要性的专用组件的芯片技术;
持续时间: 2001年~2008年More Moore 15家公司:ASML, Phystex, Zeiss, AMTC, Philips EUV, XTREME Technologies, FOCUS, SIGMA-C, AZ Electronic Materials, Schott Lithotec, Philips, XENOCS, Sagem Défense Sécurité Imagine Optic, EPPRA and Media Lario. Academic;
10个研究所:IMEC, CEA Leti, CNRS, TNO, FOM Rijnhuizen, Fraunhofer Institute, ISAN and IPM RAS (Russian Institutes of Science), ENEA, ELETTRA, NCSR;
4所大学:Bielefeld, Mainz, Delft和Birmingham [27]旨在促进欧洲极紫外光刻(EUVL)的发展;
持续时间: 2003年~2006年EXEPT 项目领导者:Gerold Alberga, ASML;
项目参与者: Adixen Vacuum Products AMTC, ASML, Bruker Advanced Supercon GmbH, Carl Zeiss SMT GmbH, Dynamic Micro Systems, Semiconductor Equipment GmbH, FOM institute DIFFER, Fraunhofer Institute for Integrated Systems and Device Technology (IISB), IMEC-Interuniversitair Micro-Electronica Centrum VZW, IMS Chips, Media Lario Technologies, SAGEM Défense Sécurité, SUSS MicroTec Photomask, Equipment GmbH & Co.KG, Xenocs, XTREME Technologies GmbH[28]探索将光刻工艺扩展到22 nm、16 nm甚至11 nm节点的可能性;
持续时间: 2009年~2012年ASET(Association for Super-Advanced Electronics Technologies) 姬路工业大学高度产业科学技术研究所,东北大学科学计测研究所,大阪大学产业科学研究所,Hoya,NTT,Nikon,Canon等[29] 专注于掩模和抗蚀剂技术的开发,主要方向是开发面向21世纪的16 GB-DRAM所需的集成电路技术;
持续时间: 1996年~2001年EUVA(Extreme Ultraviolet Lithography System Deve-lopment Association) 5家装备公司: Ushio, Canon, Nikon, Komatsu, Gigaphoton;
4家半导体器件制造商: Toshiba, NEC, Fujitsu, 和Renesas Technology[30]对EUV光源和光刻工具进行广泛的研究;
持续时间: 2001年~2011年SELETE 以东芝、日本电气、瑞萨和富士通4家公司为核心[31] 专注于掩模和抗蚀剂技术的开发,以研究和开发45 nm和32 nm节点的实用制造工艺为主;
创建时间: 2006年EIDEC(Evolvingnano-
process Infrastructure Development Center)由东芝领军,由11间日本企业共同出资设立,EIDEC已经和ASML等不少半导体大厂合作,包括英特尔和三星, 台积电和瑞萨电子于2011年加入; 除了半导体厂外,日本国内也有不少感光材料厂和掩模厂加入EIDECm, 其中JSR、信越化学工业、东京应化工业3家感光树脂大厂的合计市场占有率就高达7成, 大日本印刷及凸版印刷等各掩模厂的合计市场占有率也足足达到5成[32] 致力于研究深紫外线微影技术;
持续时间: 2011年~2019年表 2 与ASML共同在Advanced Lithography会议上发表论文的机构
Table 2 Institutions that co-publish papers at the Advanced Lithography conference with ASML
国家 序号 机构名称 领域 美国 1 Global Foundries 代工厂 2 IBM 芯片制造商 3 AMD 芯片制造商 4 Micron Technology 芯片制造商 5 Intel 芯片制造商 6 Inpria 光刻胶 7 Cymer EUV光刻机光源供应商 8 Rohm & Haas 光刻胶 9 LBNL 美国能源部三大国家实验室之一,拥有12名诺贝尔奖获得者,EUV LLC成员 10 SNL 美国能源部三大国家实验室之一,研发LPP光源,EUV LLC成员 11 LLNL 美国能源部三大国家实验室之一,最早研究EUV光刻的机构,EUV LLC成员 12 University at Albany, State University of New York ASML的ADT安装地 13 SEMATECH 战略联盟,其宗旨是加速美国半导体产业的技术创新向制造方案的商业化转化 14 Shipley Company LLC 光刻胶 15 Mentor 电子设计自动化软件等电子设计自动化工具 16 National Institute of Standards and Technology 计量标准、测量 17 Lam Research 半导体设备 18 Rigaku Innovative Technologies 光学镀膜 19 Zygo Corporation 光学测量 20 Synopsys 光刻仿真软件 21 AGC Electronics America 光学材料,掩模基板 22 University of California, University of Wisconsin System, MIT, University of Arizona, New Jersey City University, University of Texas System, Rochester Institute of Technology, Stanford University, Cornell University 探索性研究 23 Integris Inc 掩模辅助工具 24 Nanometrics Inc 晶圆检测 25 HermesMicrovision 晶圆检测 26 KLA-Tencor 晶圆检测 德国 1 Carl Zeiss AG 光学系统 2 Advanced Mask Technology Center 掩模 3 Fraunhofer-Gesellschaft 微电子器件 4 Physikalisch-Technische Bundesanstalt 计量与测试 5 GermanyoptiX Fab EUV产品初创公司,2012年成立,商品化IOF的 6 XTREME Technologies GmbH 光源 7 Forschungzentrum Dresden 光源 8 BLV Licht-und Vakuumtechnik GmbH 光源 日本 1 TOSHIBA 微电子产品 2 Tokyo Electron Limited 涂胶、显影设备 3 Osaka University 大学 4 JSR Corporation 光刻胶 5 JSR MICRO 光刻胶 6 Toppan 掩模 7 Hoya Corporation 掩模 8 EUVL Infrastructure Development Center 专注于EUV光刻的合作研发组织,东芝领军 荷兰 1 The Netherlands Organization for Applied Scientific Research 国家科研机构 2 Philips ASML母公司 3 The Dutch Institute for Fundamental Energy Research 同步辐射源 4 University of Twente 大学 5 Leiden University 大学 6 Technische Universiteit Delft 大学 7 Eindhoven University of Technology 大学 8 ASML EUV光刻机供应商 瑞士 1 Paul Scherrer Institute 光源 2 Swiss Federal Institute of Technology in Zurich 大学 3 EULITHA AG 光刻设备及零件 4 STMicroelectronics 芯片商 比利时 1 IMEC 比利时微电子研究所,ASML的测试机安装场所 2 Catholic University of Leuven 大学 3 ASM International 半导体材料 法国 1 Sagemcom 电子产品 2 FranceXenocs 分析测试仪器 韩国 1 SKhynix 芯片商 2 Samsung 芯片商 中国 1 Shanghai IC R&D Center 科研机构 2 ChangXin Memory Technologies, Inc. 代工厂 新加坡 1 Chartered Semiconductor 代工厂 2 National University of Singapore 大学 巴基
斯坦1 University of Agriculture, Faisalabad 大学 2 The University of Sindh 大学 波兰 1 Military University of Technology in Warsaw 光源 俄罗斯 1 Institute of Laser Physics(ILP) 光源 英国 1 Oxford Instruments 20世纪90年代与ASML公司合作EUV光刻项目 捷克 1 Czech Technical University in Prague 光源 爱尔兰 1 University College Dublin 光源 -
[1] BARDEEN J, BRATTAIN W H. The transistor, a semi-conductor triode[J]. Proceedings of the IEEE, 1998, 86(1): 29-30. DOI: 10.1109/JPROC.1998.658753
[2] TIETZ T. Jack kilby-inventor of the integrated circuit[EB/OL]. (2012-06-20)[2021-06-15]. http://scihi.org/jack-kilby-inventor-integrated-circuit.
[3] DRAPER D. TSMC's 5 nm (FinFET) process technology[EB/OL]. (2020-02-05)[2021-06-15]. https://www.tsmc.com/english/dedicatedFoundry/technology/logic/l_5nm.
[4] HUTCHESON G D. Moore's law, lithography, and how optics drive the semiconductor industry[J]. Proceedings of the SPIE, 2018, 10583: 1058303.
[5] 姚长呈, 巩岩. 深紫外光刻投影物镜温度特性研究[J]. 中国激光, 2016, 43(5): 0516001. https://www.cnki.com.cn/Article/CJFDTOTAL-JJZZ201605036.htm YAO Ch Ch, GONG Y. Research on temperature distribution of deep ultraviolet lithographic projection objective[J]. Chinese Journal of Lasers, 2016, 43(5): 0516001(in Chinese). https://www.cnki.com.cn/Article/CJFDTOTAL-JJZZ201605036.htm
[6] 何立文, 罗乐, 孟钢, 等. 新型光刻技术研究进展[J]. 激光技术, 2019, 43(1): 30-37. DOI: 10.7510/jgjs.issn.1001-3806.2019.01.007 HE L W, LUO L, MENG G, et al. Recent progress of novel photolithography technologies[J]. Laser Technology, 2019, 43(1): 30-37(in Chinese). DOI: 10.7510/jgjs.issn.1001-3806.2019.01.007
[7] SPIE. SPIE advanced lithography conference proceedings browse proceedings (1997-2019)[EB/OL]. [2021-12-10]. https://www.spiedigitallibrary.org/conference-proceedings-of-spie/browse/SPIE-Advanced-Lithography.
[8] ASML. The TWINSCAN NXE: 3600D is ASML's latest-generation lithography system, supporting EUV volume production at the 5 and 3 nm Logic nodes and leading-edge DRAM nodes[EB/OL]. [2022-03-19]. https://www.asml.com/en/products/euv-lithography-systems/twinscan-nxe-3600d.
[9] KINOSHITA H, KANEKO T, TAKEI H, et al. Study on X-ray reduction projection lithography[C]//47th Autumn Meeting Japan Society of Applied Physics. New York, USA: IEEE, 1986: 28-ZF15.
[10] BASOV N G, VERGUNOVA G A, VOLOSEVICH P P, et al. Conversion of laser radiation into thermal self-radiation of a plasma[J]. Soviet Journal of Quantum Electronics, 1987, 17(9): 1203. DOI: 10.1070/QE1987v017n09ABEH009901
[11] SILFVAST W T, WOOD Ⅱ O R. Tenth micron lithography with a 10 Hz 37.2 nm sodium laser[J]. Microelectronic Engineering, 1988, 8(1/2): 3-11.
[12] YEN A. EUV Lithography: From the very beginning to the eve of manufacturing[J]. Proceedings of the SPIE, 2016, 9776: 977632. DOI: 10.1117/12.2236044
[13] 木下博雄. X線工学とその応用超精密軟X線光学系の開発と応用EUV リソグラフィ[J]. レーザー研究, 1999, 27(1): 20-24(in Japanese). [14] BAKSHI V. EUV lithography[M]. Washington DC, USA: SPIE Press, 2009: 63-65.
[15] NAULLEAU P P, GOLDBERG K A, ANDERSON E H, et al. Static EUV micro-exposures using the ETS Set-2 optics[C]//Emerging Lithographic Technologies Ⅶ. Santa Clara, California, USA: International Society for Optics and Photonics, 2003: 36-46.
[16] BENSCHOP J P H, KAISER W M, OCKWELL D C. Euclides: European EUVL program[J]. Journal of Vacuum Science & Technology, 1999, B17(6): 2978-2981.
[17] MEILING H, MEIJER H, BANINE V, et al. First performance results of the ASML alpha demo tool[J]. Proceedings of the SPIE, 2006, 6151: 615108. DOI: 10.1117/12.657348
[18] WAGNER C, BACELAR J, HARNED N, et al. EUV lithography at chipmakers has started: performance validation of ASML's NXE: 3100[J]. Proceedings of the SPIE, 2011, 7969: 79691F.
[19] 中国集成电路编辑部. ASML获得台积电投资11亿欧元[J]. 中国集成电路, 2012(9): 11. EDITORIAL BOARD OF CHINA INTEGRATED CIRCUIT. ASML received 1.1 billion euros from TSMC[J]. China Integrated Circuit, 2012(9): 11(in Chinese).
[20] RUDY P, SJOERD L, JOERG M, et al. EUV lithography: NXE platform performance overview[J]. Proceedings of the SPIE, 2014, 9048: 90481J.
[21] PIRATI A, PEETERS R, SMITH D, et al. EUV lithography performance for manufacturing: Status and outlook[J]. Proceedings of the SPIE, 2016, 9776: 97760A.
[22] SCHOOT J V, SETTEN E V, TROOST K, et al. High-NA EUV lithography exposure tool: Program progress[J]. Proceedings of the SPIE, 2020, 11323: 1132307.
[23] SUNY POLYTECHNIC INSTITUTE. Sematech[EB/OL]. [2021-12-12]. http://www.sematech.org.
[24] 胡冬云. 产业技术创新联盟中的政府行为研究——以美国SEMATECH为例[J]. 科技管理研究, 2010, 30(18): 21-24. https://www.cnki.com.cn/Article/CJFDTOTAL-KJGL201018008.htm HU D Y. Study on the government behavior in industrial technology innovation consortia: A case study of SEMATECH[J]. Science and Technology Management Research, 2010, 30(18): 21-24(in Chinese). https://www.cnki.com.cn/Article/CJFDTOTAL-KJGL201018008.htm
[25] BENSCHOP J P H, KAISER W M, OCKWELL D C. EUCLIDES: The European EUVL program[J]. Emerging Lithographic Technologies Ⅲ, 1999, 3676: 246-252.
[26] MEDEA CO. MEDEA+[EB/OL]. [2021-12-22].
[27] EMERALD GROUP PUBLISHING LIMITED. "More Moore" shows European EUV innovation at EUV 2006 in Barcelona[EB/OL]. [2021-12-22]. https://www.emerald.com/insight/content/doi/10.1108/mi.2007.21824aab.006/full/html.
[28] CATRENE. Cluster for application and technology research in europe on nanoelectronics[EB/OL]. [2021-12-22]. http://www.catrene.org.
[29] OKAZAKI S. EUV lithography research program at ASET[C]//Emerging Lithographic Technologies Ⅲ. New York, USA: International Society for Optics and Photonics, 1999: 238-245.
[30] GIGAPHOTON. Status of world research in EUV lithography[EB/OL]. [2021-12-22]. https://www.gigaphoton.com/en/technology/euv-topics/status-of-world-research-in-euv-lithography.
[31] CHINA FERROALLOY NETWORK. Introduction and analysis of Japanese semiconductor industry[EB/OL]. [2021-12-22]. http://www.ferro-alloys.cn/News/Details/132499.
[32] DIGITIMES. TSMC joins EIDEC[EB/OL]. [2021-12-22]. http://www.eepw.com.Cn/article/120435.html.
[33] 中国科学院长春光学精密机械与物理研究所. 长春光机所承担的国家科技重大专项项目"极紫外光刻关键技术研究"顺利通过验收. [EB/OL]. (2017-06-21)[2017-07-04]. http://www.ciomp.ac.cn/xwdt/yw/201707/t20170704_4822124.html. CHANGCHUN INSTITUTE OF OPTICS FINE MECHANICS AND PHYSICS, CHINESE ACADEMY OF SCIENCES. The national science and technology project "key technology research of extreme ultraviolet lithography" undertaken by CIOMP successfully passed the acceptance[EB/OL]. (2017-06-21)[2017-07-04]. http://www.ciomp.ac.cn/xwdt/yw/201707/t20170704_4822124.html(in Chinese).
[34] 金春水. 极紫外投影光刻中若干关键技术研究[D]. 长春: 中国科学院研究生院(长春光学精密机械与物理研究所), 2003: 75-94. JIN Ch Sh. Investigation on extreme ultraviolet lithography[D]. Changchun: University of Chinese Academy of Sciences (Changchun Institute of Optics, Fine Mechanicsand Physics, Chinese Academy of Sciences), 2003: 75-95(in Chinese).
[35] 宗楠, 胡蔚敏, 王志敏, 等. 激光等离子体13.5 nm极紫外光刻光源进展[J]. 中国光学, 2020, 13(1): 28-42. https://www.cnki.com.cn/Article/CJFDTOTAL-ZGGA202001003.htm ZONG N, HU W M, WANG Zh M, et al. Research progress on laser-produced plasma light source for 13.5 nm extreme ultraviolet lithography[J]. Chinese Optics, 2020, 13(1): 28-42(in Chinese). https://www.cnki.com.cn/Article/CJFDTOTAL-ZGGA202001003.htm



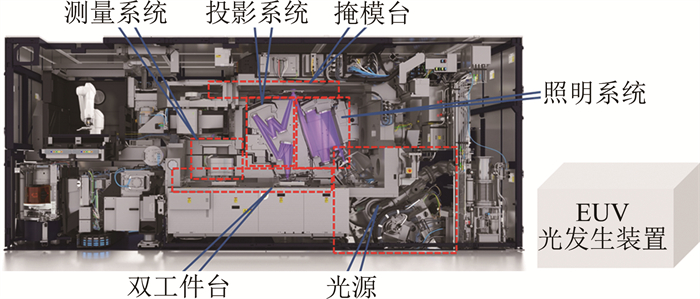
 下载:
下载: